
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Çip İstehsalında SiGe: Peşəkar Xəbər Hesabatı
Yarımkeçirici materialların təkamülü
Müasir yarımkeçirici texnologiya səltənətində miniatürləşdirmə istiqamətində amansız hərəkət ənənəvi silikon əsaslı materialların sərhədlərini itələdi. Yüksək performans və aşağı enerji istehlakı tələblərini ödəmək üçün SiGe (Silicon Germanium) unikal fiziki və elektrik xüsusiyyətlərinə görə yarımkeçirici çip istehsalında seçilmiş kompozit material kimi ortaya çıxdı. Bu məqalədə dərinləşirepitaksiya prosesiSiGe və onun epitaksial böyümədə, gərgin silikon tətbiqlərində və Gate-All-Around (GAA) strukturlarında rolu.
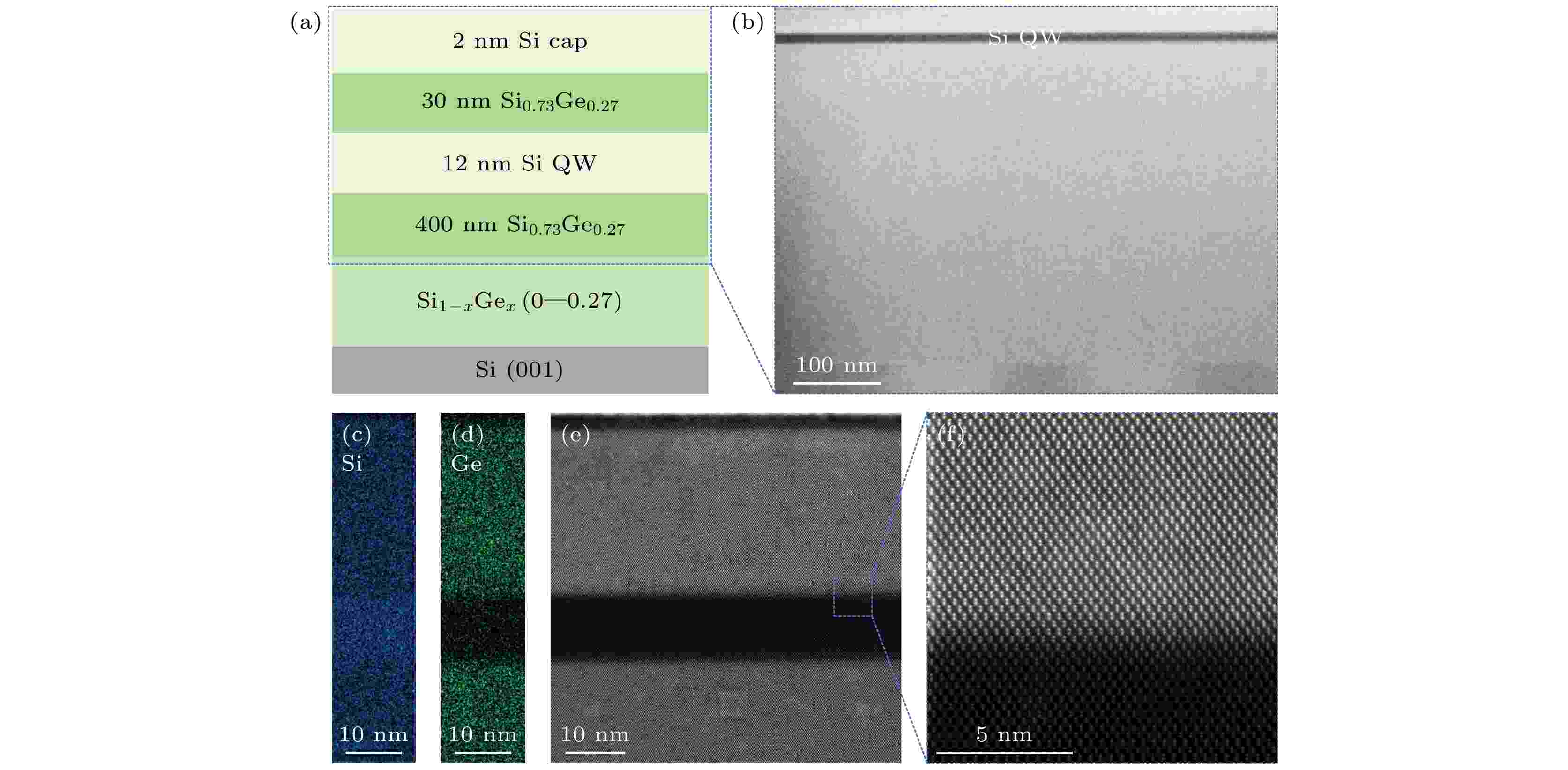
SiGe Epitaksinin əhəmiyyəti
1.1 Çip İstehsalında Epitaksiyaya Giriş:
Epitaksiya, tez-tez Epi kimi qısaldılmış, eyni qəfəs düzülüşü ilə bir kristal substratda bir kristal təbəqənin böyüməsinə aiddir. Bu təbəqə ya ola bilərhomoepitaxial (məsələn, Si/Si)və ya heteroepitaksial (məsələn, SiGe/Si və ya SiC/Si). Epitaksial böyümə üçün müxtəlif üsullardan istifadə olunur, o cümlədən Molekulyar Şüa Epitaksiyası (MBE), Ultra Yüksək Vakuum Kimyəvi Buxar Çöküntüsü (UHV/CVD), Atmosfer və Azaldılmış Təzyiq Epitaksisi (ATM və RP Epi). Bu məqalə silikonun (Si) və silikon-germaniumun (SiGe) epitaksiya proseslərinə əsas diqqəti substrat materialı kimi silisium ilə yarımkeçirici inteqral sxem istehsalında geniş şəkildə yönəldir.
1.2 SiGe Epitaxy-nin üstünlükləri:
Müəyyən bir nisbətdə germaniumun (Ge) tərkibində olmasıepitaksiya prosesiSiGe monokristal təbəqəsi əmələ gətirir ki, bu da təkcə bant genişliyini azaltmaqla yanaşı, həm də tranzistorun kəsilmə tezliyini (fT) artırır. Bu, onu simsiz və optik rabitə üçün yüksək tezlikli cihazlarda geniş şəkildə tətbiq etməyə imkan verir. Üstəlik, qabaqcıl CMOS inteqral sxem proseslərində Ge və Si arasında qəfəs uyğunsuzluğu (təxminən 4%) şəbəkə gərginliyini yaradır, elektronların və ya dəliklərin hərəkətliliyini artırır və bununla da cihazın doyma cərəyanını və cavab sürətini artırır.
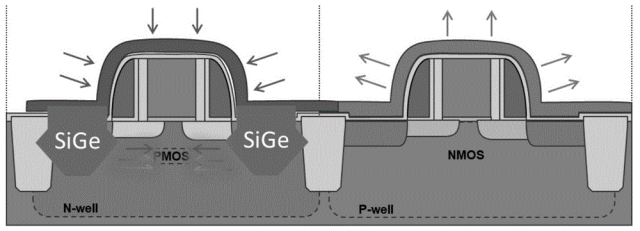
Hərtərəfli SiGe Epitaksiya Prosesi Akışı
2.1 Əvvəlcədən müalicə:
Silikon vaflilər, ilk növbədə təbii oksid təbəqəsinin və vafli səthindəki çirklərin çıxarılmasını əhatə edən istənilən proses nəticələrinə əsasən əvvəlcədən müalicə olunur. Güclü aşqarlanmış alt təbəqələr üçün, sonrakı dövrlərdə avtomatik dopinqi azaltmaq üçün arxa sızdırmazlığın zəruri olub-olmadığını nəzərə almaq çox vacibdir.epitaksiya artımı.
2.2 Artan qazlar və şərtlər:
Silikon qazları: Silan (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂) və Trichlorosilane (TCS, SiHCl₃) ən çox istifadə edilən üç silikon qaz mənbəyidir. SiH₄ aşağı temperaturda tam epitaksiya prosesləri üçün uyğundur, sürətli böyümə sürəti ilə tanınan TCS isə qalın təbəqələrin hazırlanması üçün geniş istifadə olunur.silikon epitaksiyasıtəbəqələr.
Germanium qazı: Germane (GeH₄) germanium əlavə etmək üçün əsas mənbədir, SiGe ərintiləri yaratmaq üçün silikon mənbələri ilə birlikdə istifadə olunur.
Selektiv epitaksiya: Selektiv böyümə nisbi nisbətlərin tənzimlənməsi ilə əldə edilirepitaksial çökməvə xlor tərkibli silisium qazı DCS istifadə edərək in situ aşındırma. Seçicilik, Cl atomlarının silisium səthində adsorbsiyasının oksidlər və ya nitridlərdən daha az olması ilə əlaqədardır və epitaksial böyüməni asanlaşdırır. Cl atomları olmayan və aktivləşmə enerjisi aşağı olan SiH₄ ümumiyyətlə yalnız aşağı temperaturda tam epitaksiya proseslərinə tətbiq edilir. Digər tez-tez istifadə olunan silikon mənbəyi olan TCS, aşağı buxar təzyiqinə malikdir və otaq temperaturunda mayedir, onu reaksiya kamerasına daxil etmək üçün H₂ köpüyü tələb edir. Bununla belə, nisbətən ucuzdur və tez-tez silikon epitaksiya vafli istehsalında geniş tətbiq olunan qalın silisium epitaksi təbəqələrini yetişdirmək üçün sürətli böyümə sürəti (5 μm / dəq-ə qədər) üçün istifadə olunur.
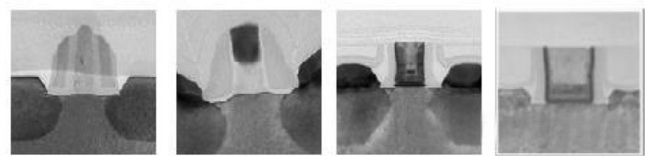
Epitaksial təbəqələrdə gərilmiş silikon
ərzindəepitaksial böyümə, epitaksial monokristal Si rahatlamış SiGe qatında çökdürülür. Si və SiGe arasındakı qəfəs uyğunsuzluğuna görə, Si monokristal təbəqəsi NMOS tranzistorlarında elektron hərəkətliliyini əhəmiyyətli dərəcədə artıraraq, əsas SiGe təbəqəsindən dartılma stresinə məruz qalır. Bu texnologiya nəinki doyma cərəyanını (Idsat) artırır, həm də cihazın cavab sürətini artırır. PMOS cihazları üçün, SiGe təbəqələri kanalda sıxılma gərginliyi yaratmaq, deşiklərin hərəkətliliyini artırmaq və doyma cərəyanını artırmaq üçün aşındırıldıqdan sonra mənbə və drenaj bölgələrində epitaksial olaraq böyüdülür.
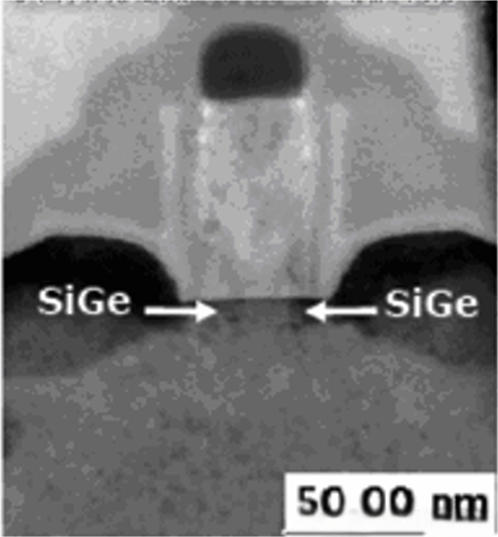
SiGe, GAA strukturlarında qurbanlıq təbəqə kimi
Gate-All-Around (GAA) nanotel tranzistorlarının istehsalında SiGe təbəqələri qurbanlıq təbəqələr kimi çıxış edir. Kvaziatomik təbəqənin aşındırılması (kvazi-ALE) kimi yüksək seçici anizotropik aşındırma üsulları nanotel və ya nanosheet strukturları yaratmaq üçün SiGe təbəqələrinin dəqiq çıxarılmasına imkan verir.
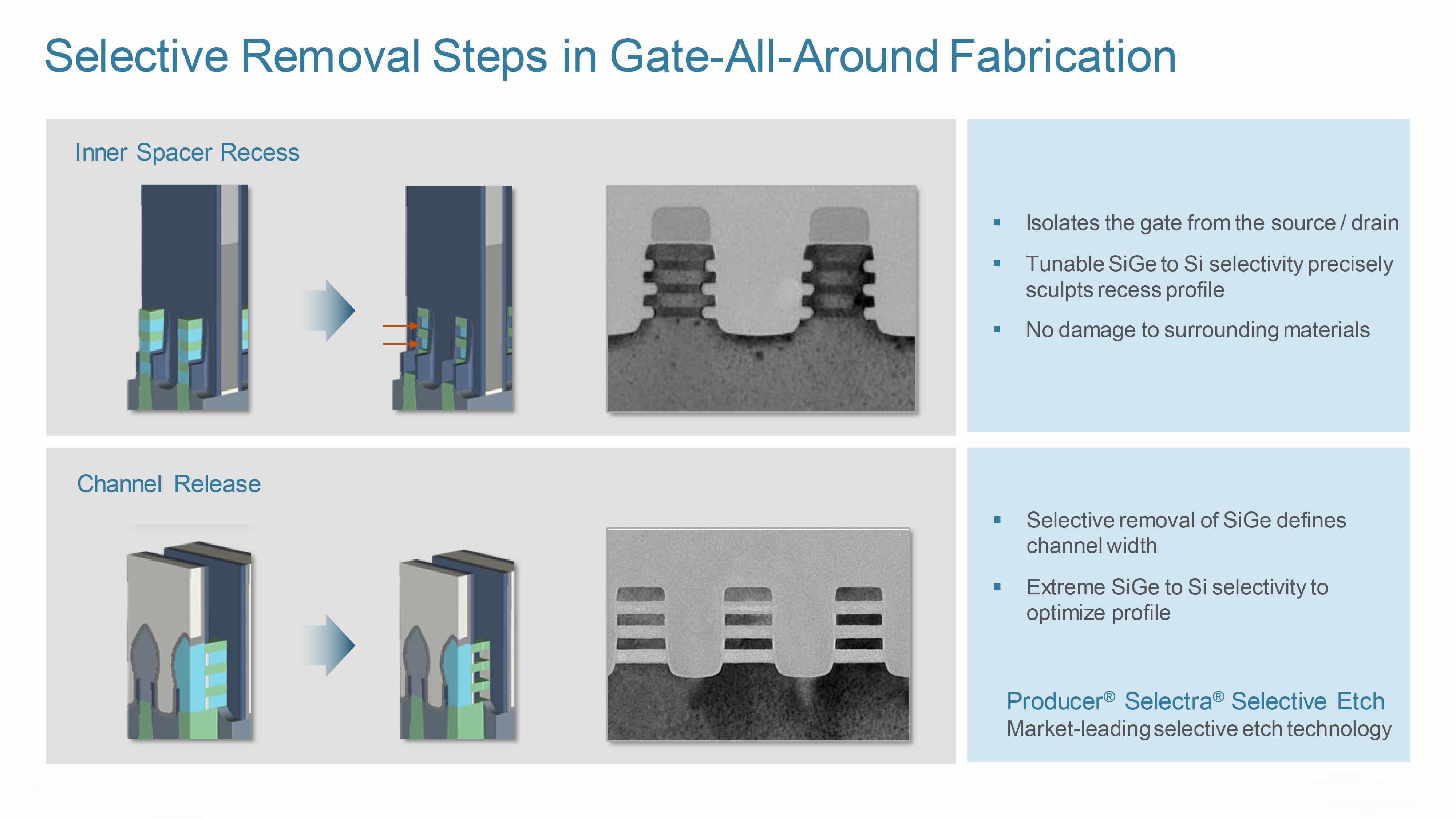
Semicorex-də biz ixtisaslaşmışıqSiC/TaC ilə örtülmüş qrafit məhlullarıYarımkeçirici istehsalında Si epitaksial artımda tətbiq olunur, hər hansı bir sorğunuz varsa və ya əlavə məlumatlara ehtiyacınız varsa, bizimlə əlaqə saxlamaqdan çəkinməyin.
Əlaqə telefonu: +86-13567891907
E-poçt: sales@semicorex.com




