
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Yarımkeçiricilər Sənayesində Quru Aşınma Texnologiyasını Anlamaq
Aşınma, dizayn edilmiş struktur nümunələrinə nail olmaq üçün fiziki və ya kimyəvi vasitələrlə materialın seçici şəkildə çıxarılması texnikasına aiddir.
Hal-hazırda, bir çox yarımkeçirici qurğular əsasən iki növ aşındırma yolu ilə yaradılan mesa cihaz strukturlarından istifadə edir:yaş aşındırma və quru aşındırma. Sadə və sürətli nəm aşındırma yarımkeçirici qurğuların hazırlanmasında mühüm rol oynasa da, onun izotrop aşındırma və zəif vahidlik kimi özünəməxsus çatışmazlıqları var ki, bu da kiçik ölçülü nümunələri köçürərkən məhdud nəzarətlə nəticələnir. Quru aşındırma, yüksək anizotropiya, yaxşı vahidlik və təkrarlanma qabiliyyəti ilə yarımkeçirici cihazların istehsal proseslərində görkəmli hala gəldi. “Quru aşındırma” termini geniş mənada səth materiallarının çıxarılması və mikro və nano naxışların ötürülməsi üçün istifadə olunan hər hansı yaş olmayan aşındırma texnologiyasına aiddir, o cümlədən lazerlə aşındırma, plazma ilə aşındırma və kimyəvi buxarla aşındırma. Bu mətndə müzakirə edilən quru aşındırma xüsusi olaraq material səthlərini dəyişdirmək üçün plazma axıdılması - fiziki və ya kimyəvi - istifadə edən proseslərin dar tətbiqinə aiddir. O, daxil olmaqla bir neçə ümumi sənaye aşındırma texnologiyalarını əhatə edirİon şüası ilə aşındırma (IBE), reaktiv ion aşındırma (RIE), elektron siklotron rezonansı (ECR) plazma aşındırma və induktiv birləşdirilmiş plazma (ICP) ilə aşındırma.
1. İon şüası ilə aşındırma (IBE)
İon frezeleme kimi də tanınan IBE 1970-ci illərdə sırf fiziki aşındırma üsulu kimi işlənib hazırlanmışdır. Proses, hədəf materialın səthini bombalamaq üçün gərginliklə sürətləndirilən inert qazlardan (Ar, Xe kimi) yaradılmış ion şüalarını əhatə edir. İonlar enerjini səth atomlarına ötürür və enerjisi onların bağlanma enerjisindən çox olanların sıçramasına səbəb olur. Bu texnika ion şüasının istiqamətini və enerjisini idarə etmək üçün sürətləndirilmiş gərginlikdən istifadə edir ki, bu da əla aşındırma anizotropiyası və sürətin idarə olunması ilə nəticələnir. Keramika və müəyyən metallar kimi kimyəvi cəhətdən dayanıqlı materialların aşındırılması üçün ideal olsa da, daha dərin aşırmalar üçün daha qalın maskalara ehtiyac aşındırma dəqiqliyini poza bilər və yüksək enerjili ion bombardmanı şəbəkənin pozulması səbəbindən qaçınılmaz elektrik zədələnməsinə səbəb ola bilər.

2. Reaktiv İon Aşınması (RIE)
IBE-dən hazırlanmış RIE kimyəvi reaksiyaları fiziki ion bombardmanı ilə birləşdirir. IBE ilə müqayisədə RIE daha yüksək aşındırma dərəcələri və əla anizotropiya və geniş ərazilərdə vahidlik təklif edir ki, bu da onu mikro və nano istehsalda ən geniş istifadə olunan aşındırma üsullarından birinə çevirir. Proses paralel boşqab elektrodlarına radiotezlik (RF) gərginliyinin tətbiqini nəzərdə tutur ki, bu da kameradakı elektronların reaksiya qazlarını sürətləndirməsinə və ionlaşmasına səbəb olur ki, bu da plitələrin bir tərəfində sabit plazma vəziyyətinə gətirib çıxarır. Plazma elektronların katoda cəlb edilməsi və anoda əsaslanması səbəbindən müsbət potensial daşıyır və beləliklə, kamera boyunca elektrik sahəsi yaradır. Müsbət yüklü plazma katodla əlaqəli substrata doğru sürətlənərək onu effektiv şəkildə aşındırır.
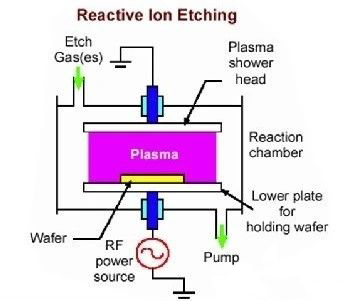
Aşınma prosesi zamanı kamera aşağı təzyiqli mühiti (0,1~10 Pa) saxlayır, bu da reaksiya qazlarının ionlaşma sürətini artırır və substrat səthində kimyəvi reaksiya prosesini sürətləndirir. Ümumiyyətlə, RIE prosesi yüksək aşındırma dəqiqliyini təmin edərək, vakuum sistemi tərəfindən effektiv şəkildə çıxarılmaq üçün reaksiya əlavə məhsullarının uçucu olmasını tələb edir. RF güc səviyyəsi birbaşa plazma sıxlığını və sürətlənmə meylinin gərginliyini müəyyən edir və bununla da aşındırma sürətinə nəzarət edir. Bununla belə, plazma sıxlığını artırarkən, RIE həmçinin qəfəslərin zədələnməsinə səbəb ola biləcək və maskanın seçiciliyini azalda bilən əyilmə gərginliyini artırır, beləliklə, aşındırma tətbiqləri üçün məhdudiyyətlər yaradır. Genişmiqyaslı inteqral sxemlərin sürətli inkişafı və tranzistorların ölçüsünün azalması ilə mikro və nano istehsalda dəqiqlik və aspekt nisbətlərinə daha çox tələbat yarandı və bu, yüksək sıxlıqlı plazma əsaslı quru aşındırma texnologiyalarının yaranmasına səbəb oldu. elektron informasiya texnologiyalarının inkişafı üçün yeni imkanlar.
3. Elektron siklotron rezonansı (ECR) Plazma aşındırma
Yüksək sıxlıqlı plazma əldə etmək üçün erkən üsul olan ECR texnologiyası, elektron siklotron rezonansına səbəb olmaq üçün xaricdən tətbiq olunan, tezliyə uyğunlaşdırılmış maqnit sahəsi ilə gücləndirilmiş kamera daxilində elektronlarla rezonans yaratmaq üçün mikrodalğalı enerjidən istifadə edir. Bu üsul RIE-dən əhəmiyyətli dərəcədə yüksək plazma sıxlığına nail olur, aşındırma sürətini və maska seçiciliyini artırır, beləliklə, ultra yüksək aspekt nisbəti strukturlarının aşındırılmasını asanlaşdırır. Bununla belə, mikrodalğalı mənbələrin, RF mənbələrinin və maqnit sahələrinin əlaqələndirilmiş funksiyasına əsaslanan sistemin mürəkkəbliyi əməliyyat problemləri yaradır. İnduktiv şəkildə birləşdirilən plazmanın (ICP) üzə çıxması tezliklə ECR üzərində sadələşdirmə kimi izlədi.
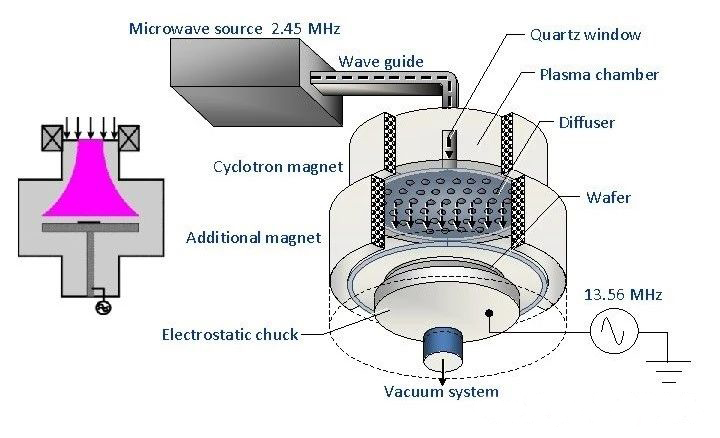
4. İnduktiv şəkildə birləşdirilən plazma (ICP) aşındırma
ICP aşındırma texnologiyası həm plazmanın yaranmasına, həm də sürətlənmə gərginliyinə nəzarət etmək üçün iki 13,56 MHz RF mənbəyindən istifadə etməklə ECR texnologiyasına əsaslanan sistemi sadələşdirir. ECR-də istifadə olunan xarici maqnit sahəsinin əvəzinə, spiral bobin sxemdə göstərildiyi kimi alternativ elektromaqnit sahəsini induksiya edir. RF mənbələri elektromaqnit birləşmə vasitəsilə enerjini induksiya edilmiş sahə daxilində siklotron hərəkəti ilə hərəkət edən daxili elektronlara ötürür və ionlaşmaya səbəb olmaq üçün reaksiya qazları ilə toqquşur. Bu quraşdırma ECR ilə müqayisə edilə bilən plazma sıxlığına nail olur. ICP aşındırma müxtəlif aşındırma sistemlərinin üstünlüklərini özündə birləşdirir, yüksək aşındırma sürəti, yüksək seçmə, geniş ərazi vahidliyi və sadə, idarə oluna bilən avadanlıq strukturu ehtiyaclarını qarşılayır və beləliklə, sürətlə yüksək sıxlıqlı plazma aşındırma texnologiyalarının yeni nəsli üçün üstünlük verilən seçimə çevrilir. .
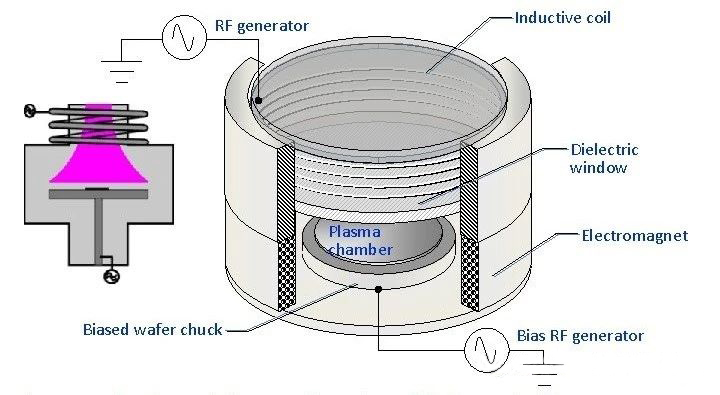
5. Quru aşındırma xüsusiyyətləri
Quru aşındırma texnologiyası yüksək anizotropiya və yüksək aşındırma sürətlərinə görə mikro və nanofabrikasiyada sürətlə əsas mövqe tutmuş, yaş aşındırmanı əvəz etmişdir. Yaxşı quru aşındırma texnologiyasını qiymətləndirmək üçün meyarlara maskanın seçiciliyi, anizotropiya, aşındırma sürəti, ümumi vahidlik və şəbəkənin zədələnməsi nəticəsində səth hamarlığı daxildir. Bir çox qiymətləndirmə meyarları ilə, xüsusi vəziyyət istehsal ehtiyaclarına əsaslanaraq nəzərə alınmalıdır. Quru aşındırmanın ən birbaşa göstəriciləri səthin morfologiyası, o cümlədən həkk olunmuş döşəmənin və yan divarların hamarlığı və həkk olunmuş terrasların anizotropiyasıdır ki, hər ikisi kimyəvi reaksiyaların fiziki bombardmana nisbətini tənzimləməklə idarə oluna bilər. Aşındırmadan sonra mikroskopik xarakteristika adətən skan edən elektron mikroskopiya və atom qüvvəsi mikroskopiyasından istifadə etməklə həyata keçirilir. Maskanın selektivliyi, yəni eyni aşındırma şərtləri və vaxtı altında maskanın aşınma dərinliyinin materialınkına nisbəti çox vacibdir. Ümumiyyətlə, seçicilik nə qədər yüksək olsa, nümunənin ötürülməsinin dəqiqliyi bir o qədər yaxşı olar. ICP aşındırmada istifadə olunan ümumi maskalara fotorezist, metallar və dielektrik filmlər daxildir. Fotorezist zəif seçiciliyə malikdir və yüksək temperatur və ya enerjili bombardman altında pisləşə bilər; metallar yüksək seçicilik təklif edir, lakin maskaların çıxarılmasında çətinliklər yaradır və çox vaxt çox qatlı maskalama üsullarını tələb edir. Bundan əlavə, metal maskalar aşındırma zamanı yan divarlara yapışaraq sızma yollarını yarada bilər. Buna görə də, aşındırma üçün uyğun maska texnologiyasının seçilməsi xüsusilə vacibdir və maska materiallarının seçimi cihazların xüsusi performans tələbləri əsasında müəyyən edilməlidir.**




